随着半导体工艺技术的发展,芯片集成度逐步的提升,封装尺寸越来越小,半导体器件面临着更高的热应力挑战。结温过高不仅降低了器件的电气性能,而且增加了金属迁移率和其他退化变化,因此导致芯片老化加速、故障率升高。根据电子设计规则,温度每升高10°C,平均寿命将降低50%,因此正确评估半导体器件的热应力或结温非常重要。
一些半导体器件集成了专用的热二极管,根据校准后的正向电压与温度曲线精确测量结温。由于大多数器件没有这种设计,结温的估计取决于外部参考点温度和封装的热阻参数。常用的封装热指标是热阻和热表征参数。下表显示了LMR14030(40V/3A BUCK,SOIC-8 Package)的典型热指标。

1.热阻参数:RθJA& RθJC是数据手册上最常见的热阻参数,几乎所有的半导体器件规格书都提供了RθJA、 RθJC,同时它也是工程师最常错误使用的。
2.热表征参数:JT&JB,是JEDEC(Solid State Technology Association)在20世纪90年代定义的热指标。这些指标更便于评估现代封装类型器件的结温。慢慢的变多的半导体制造商正在提供这些热指标。
早期的半导体器件通常封装在金属罐中。带引线的器件组装后立在PCB上,因此器件的热量几乎完全通过金属外壳散发到空气环境中。由于热传导路径单一,与PCB的关系较小,因此在这种应用条件下定义了热阻参数RθJA和RθJC。
如今,许多新的封装类型,特别是在SMD封装中,芯片结温具有不一样的热传导路径,并且与PCB设计有很大的关系,如果继续简单地用热阻参数估算结温将导致错误的结果。
RθJA是结在静止空气条件下对环境的热阻,是半导体封装最常见的热参数。在大多数情况下,器件的总热量最终分布到空气中,因此空气温度很容易测量或预先确定,只要已知功耗,就可以很容易地用RθJA估计结温。
下图显示了在PCB上组装的TO-92封装中的普通晶体管。热量主要是通过封装体传导,与PCB的关系较小,因为它的引脚直插在PCB上。利用其典型的RθJA,就能够准确的通过环境温度(或外壳温度)和器件功耗获得准确的结温估计结果。

下图的SOIC-8由于封装的底部暴露的thermal pad是焊接到PCB上的,所以大部分的热量都是通过PCB传导的。器件与PCB构成一个热子系统,则RθJA为系统级热阻参数。任何PCB设计上的差异,如电路板类型、尺寸、层数、铜箔厚度、过孔数量等,都会对最终的热性能产生重大影响。
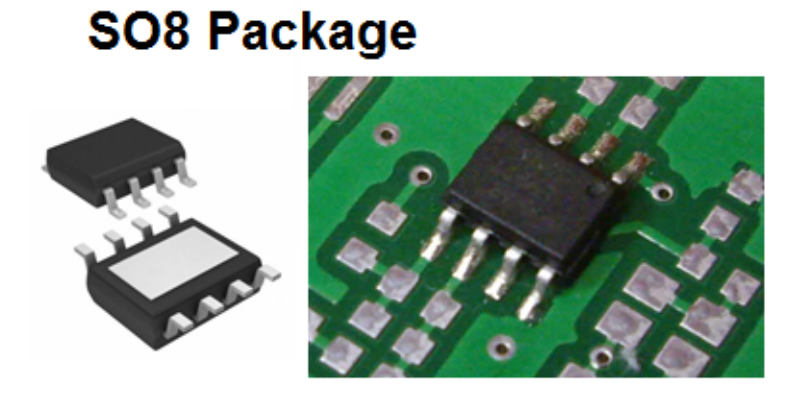
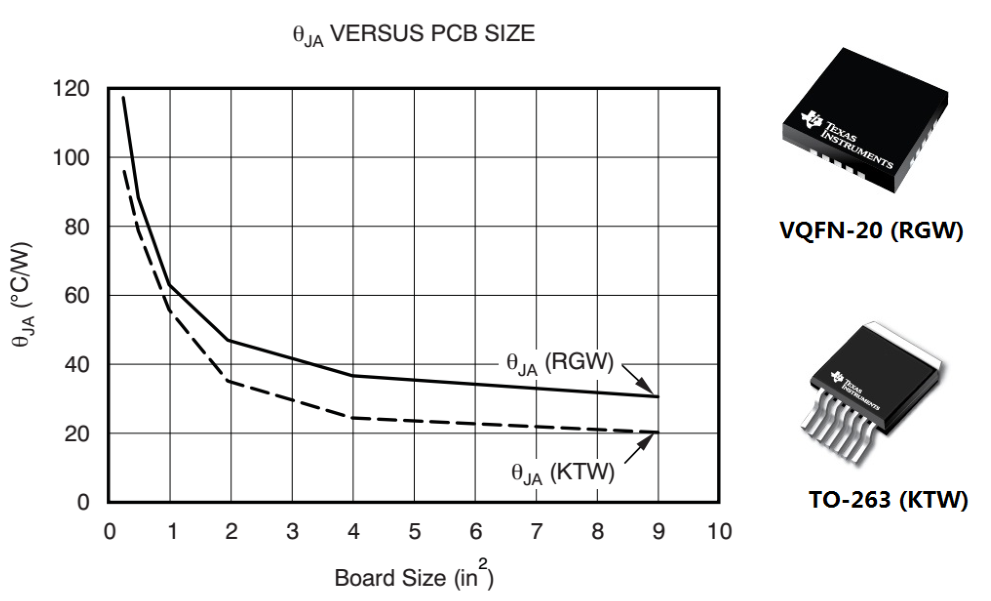
数据手册中提供的RθJA通常是在JEDEC或设备供应商定义的标准PCB上测量或模拟得到的。如果你的PCB设计和应用环境与JEDEC或设备供应商定义的条件相似,则可以使用数据表RθJA参数,也可以使用实际的RθJA参数。这些是在以前类似的产品系统中测量到的估计结温。否则,PCB设计的差异可能导致结温估计的大误差。估计值越低,直接导致可靠性越差。
根据JEDEC的建议,在实际应用中,RθJA参数不适合用于估计结温。更适合于比较相同封装类型下不同器件的热性能,必须注意的是,这种比较是基于类似的PCB设计。
RθJC定义为结与外壳表面(顶部或底部)之间的热阻。下图为RθJC的测量示意图。
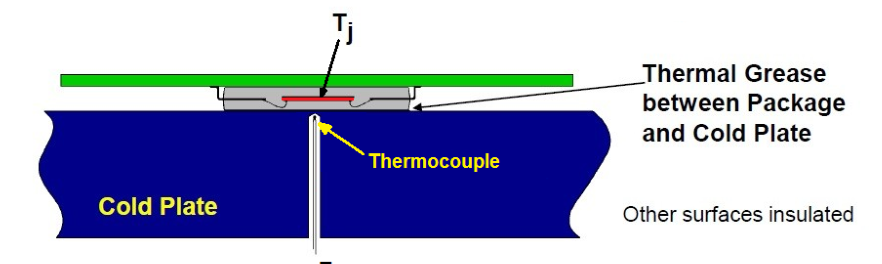
测试方法迫使几乎所有的散热都通过器件的单表面(壳体顶部或封装底部),因此Rθ适用于芯片的散热功率通过器件封装的单表面(壳体顶部或底部)传导的情况。这意味着RθJC参数通常适用于仅在封装的顶部(或底部)安装散热片的情况,其中90%以上的热量从顶部(或底部)散热,这与JEDEC测试条件非常相似。对于带有底部thermal pad的封装,允许将底部thermal pad焊到PCB上,但对于RθJC-top参数,必须确保顶部是散热的主要路径。
对于没有顶部散热的典型塑料封装SMD器件,仅通过测量外壳顶部温度和计算器件功耗来估计RθJC结温是不正确的。这可能导致估算的值比实际结温高得多。
使用RθJC参数的难点在于如何准确测量与散热器相连的封装的表面温度。测量外壳温度可以使用(按精度顺序)红外相机,荧光光学探头,热电偶或红外枪。
使用热电偶的一般方法是在散热器与芯片封装接触的中心部位钻一个直径≤1mm的通孔。插入一根细细的热电偶导线规格,J或K线),并与封装表面良好接触,在侧面涂上不大于2 × 2mm的导热环氧树脂。
RθJB参数定义晚于上述两个参数。RθJB定义为结到PCB(不是封装底部)的热阻,这意味着PCB必须是器件散热的主要路径。下图显示了JEDEC测试方法。
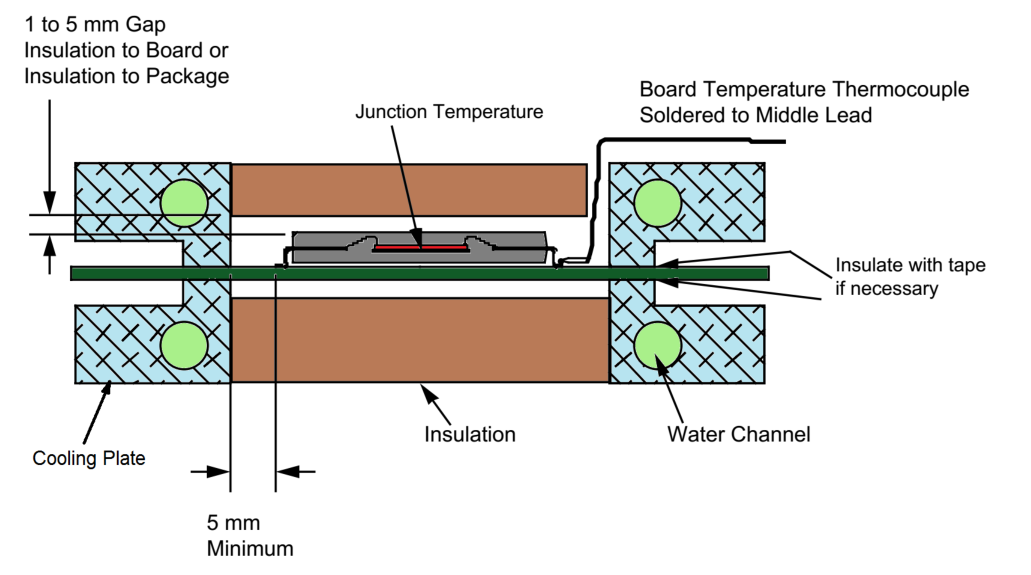
它使用圆形冷却板夹紧PCB的顶部和底部。它还使用隔热材料覆盖芯片的顶部和底部位置,以确保几乎所有的热量都流向PCB。
RθJB参数更适合于SMD封装类型的器件来估计结温,特别是具有thermalpad的封装。在实际应用中要注意PCB设计,因为JEDEC测试RθJB的是材料为FR4、4层、1.6 mm厚度的高导热PCB (High-K PCB)。顶层和底层的铜箔厚度是2盎司。中间两层为1oz。单板尺寸通常为11.4 cm×7.6 cm或11.4 cm×10.2 cm。如果实际应用中的PCB设计类似或更优化,则使用此参数估计结温。有时测量PCB温度不方便,因为热电偶需要放置在靠近封装边缘的1mm空间内,因此JEDEC定义了参数以更易于使用。
根据热阻的定义,它是两点之间的温差与实际传导热功率之比。如下图所示,实际应用系统有多种冷却路径。
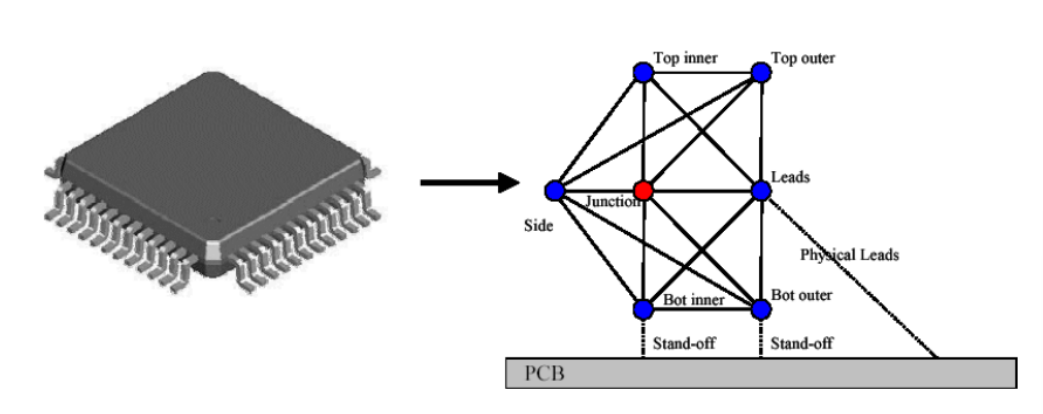
该模型相当于一个复杂的串联/并联电路网络,难以简单地计算或确定某条路径上实际传导的热功率。JEDEC测试热阻的方式总是迫使几乎所有的设备热流到参考点。原因很简单,就是用芯片的总功耗来计算热阻。实际系统中热传导路径的复杂性决定了结温不能简单地通过总耗散功率和热阻参数来估算。为此,JEDEC定义了热表征参数,虽然其计算公式与单位(°C/W) Rθ非常相似,该参数仅表示芯片的温度差(结与参考点之间)与总耗散功率的比值,它只是一个系数。
现在有两个常见的热特性参数:JT用于连接到封装顶部,JB用于连接到PCB。JT更常被使用,因为:它更方便测量外壳顶部温度,并且SMD芯片主要通过PCB散热,只有少量热量流向顶部。另外,连接到顶部的温差通常小于连接到PCB的温差。换句话说,JT小于JB,因此使用JT参数的误差相对较小。
如果比较热阻,参数的主要优点之一是对PCB尺寸的依赖性较小。下图显示了这种关系。
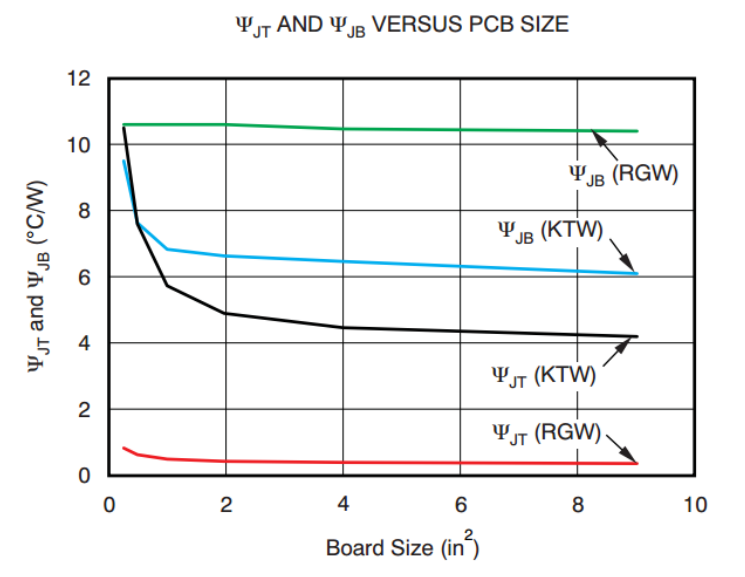
参数克服了θ参数对PCB的依赖性,因此在热设计中更方便,估算结果也更准确。但如果芯片连接到散热器,则必须使用RθJC或JS(散热器的结)来估计结温度。

1.测壳温度:温度测量常用热电偶和红外热成像仪。当热电偶测量温度时,必须使用细规格线规格,J或K型线),以尽量减少热电偶的局部冷却。必须贴在封装表面正中间(±1mm),两侧用不大于2mm × 2mm的导电环氧树脂包芯。
不建议将热电偶粘在封装表面。为了尽量减少热电偶的散热影响,电线必须沿着封装的对角线进行敷设,直到PCB表面,并且在从PCB抬起之前至少要有25mm的距离。热电偶导线可以用胶带粘接在PCB上。使用不正确的热电偶线%的测量误差。
用红外热成像仪测量温度简单、方便、快速、准确。依据环境温度或试验环境的变化,机器在试验前需要有足够的预热稳定时间。一定要校正所测表面****率的读数。在被测物体上选择高****率表面(非金属、粗糙、低反射)作为测试点。对于低****率的表面,使用黑色绝缘胶带,喷漆或使用黑色水性手写笔。在测试点的顶部垂直测试它,测试区域需要很集中并且完整充满显示窗口。
2.测空气温度:对于空气环境和温度的测量,PCB必须水平放置。测量空气温度在点2.54厘米下的PCB中心和2.54厘米的水平侧。取两个点的平均温度。
3.对于PCB温度测试点,选择封装侧最靠近内部芯片的中间位置。测量距离封装边缘1mm范围内的电路板温度,或者在设备供应商推荐的测试点测量。最优选择一个铜箔布线和连接到包装上的点。测量前刮擦阻焊膜。对于带铅封装器件的实际操作,请选择封装长侧的中心引脚,测量焊接到PCB上的引脚端温度。如果引脚焊盘到封装边缘的空间大于1.5 mm,则直接测量电路板上的温度。
如果系统两点之间的热传导路径和热功率明确,热阻参数可拿来估计温差。在实际应用中,热传导路径是多种多样的,热量通过多个通道传播。与总功耗不同,很难估计特定路径的功耗。由于这些原因,热表征参数更适合于估计结温。

*博客内容为网友个人发布,仅代表博主个人自己的观点,如有侵权请联系工作人员删除。


